De procesmethode van blinde en ondergrondse via's
1. Diepteboormethode
Gebruik mechanisch om de diepte van de jaloezie te boren om de verbinding tussen de binnenlaag en de buitenlaag te bereiken. Het nadeel van deze methode is de lage productiviteit, omdat er slechts één stuk tegelijk kan worden bewerkt. Bovendien is de verwerking een uitdaging en komt de betrouwbaarheid in gevaar.

2. Sequentieel lamineren
Door herhaaldelijk te drukken ontdekte ik achtereenvolgens de begraven via's, de blinde via's en het doorgaande gat. De zwakte van deze methode is dat het niet eenvoudig is om de uitzetting te controleren na herhaaldelijk drukken; de verwerking duurt ook lang. Met deze methode zijn geen kruisblinde en begraven via's mogelijk.
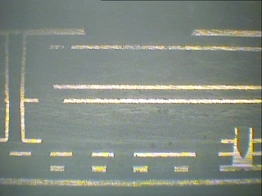
Blind via(L2-L4,L4-L8)
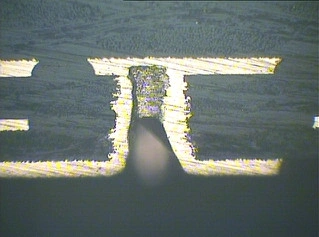
Blinde via's (L1-L3)
3. HDI-opbouw
De methode van laserboren wordt laag voor laag vergroot voor progressief lamineren. Nadelen: hoge apparatuurvereisten, hoog plateervermogen en hoge kosten.